半导体等离子清洗机的核心作用是什么?
文章导读:半导体等离子清洗机是半导体制造流程中关键的工艺设备之一,其核心作用围绕去除污染物、改善材料表面特性、保障后续工艺兼容性与器件性能稳定性展开,具体可拆解为以下四大核心方向,覆盖半导体前道、中道、后道的多个关键环节:
半导体等离子清洗机是半导体制造流程中关键的工艺设备之一,其核心作用围绕去除污染物、改善材料表面特性、保障后续工艺兼容性与器件性能稳定性展开,具体可拆解为以下四大核心方向,覆盖半导体前道、中道、后道的多个关键环节:
 一、高效去除表面微污染物(最基础且关键的功能)
一、高效去除表面微污染物(最基础且关键的功能)
半导体器件(如芯片、晶圆、封装件)在制造过程中(如光刻、沉积、蚀刻、切割后),表面极易残留微米 / 纳米级污染物,这些污染物会直接导致器件漏电、良率下降甚至失效。等离子清洗机通过 “物理轰击 + 化学反应” 双重作用,实现精准、无损伤的污染物去除,具体包括:
有机污染物去除:如光刻胶残留、清洗剂残留、手指油污、聚合物杂质等。
原理:通入氧气(O₂)、空气等氧化性气体,等离子体中的高能氧自由基(・O)会与有机污染物发生氧化反应,将其分解为 CO₂、H₂O 等挥发性气体,再通过真空泵排出。
应用场景:光刻后残留胶去除、晶圆键合前表面清洁、封装引线键合区(Bond Pad)清洁。
无机污染物去除:如金属离子(Cu、Fe、Al 等)、氧化物(SiO₂、Al₂O₃等)、颗粒杂质(硅粉、金属碎屑)。
原理:
物理轰击:通入氩气(Ar)等惰性气体,等离子体中的高能离子(Ar⁺)会以高速撞击表面,将无机颗粒 / 氧化物 “剥离”;
化学反应:通入氢气(H₂)、氟化氢(HF,需特殊耐腐蚀腔体)等还原性 / 腐蚀性气体,与金属氧化物反应生成易挥发产物(如 H₂O、金属氟化物)。
应用场景:晶圆电镀前金属表面氧化物去除、MEMS 器件结构清洁、半导体封装焊盘(Pad)氧化层去除。
 二、表面活化与改性,提升后续工艺兼容性
二、表面活化与改性,提升后续工艺兼容性
半导体制造中,许多后续工艺(如键合、涂胶、镀膜、焊接)对材料表面的 “附着力”“浸润性” 要求极高,而原生半导体表面(如硅、陶瓷、金属)往往存在疏水性或低活性,导致工艺失效(如键合开裂、涂胶不均)。等离子清洗机通过以下方式实现表面改性:
表面活化:打破材料表面原有化学键(如 C-C 键、Si-O 键),引入羟基(-OH)、羧基(-COOH)等极性基团,使表面从 “疏水” 变为 “亲水”,显著提升后续涂胶、镀膜的附着力。
例:晶圆键合(如直接键合、阳极键合)前,用 O₂或 N₂+H₂混合等离子处理硅片表面,活化后的表面能从 30 mN/m 提升至 60+ mN/m,确保键合强度达标。
表面刻蚀(微粗糙化):对表面进行 “微米级浅刻蚀”,形成微小凹凸结构(粗糙度 Ra 提升至 10-100nm),通过 “机械咬合” 进一步增强后续工艺的结合力。
应用场景:半导体封装中 “芯片 - 基板” 的粘片(Die Attach)前处理、柔性半导体(如 OLED 驱动芯片)的薄膜沉积前表面改性。


半导体器件(如芯片、晶圆、封装件)在制造过程中(如光刻、沉积、蚀刻、切割后),表面极易残留微米 / 纳米级污染物,这些污染物会直接导致器件漏电、良率下降甚至失效。等离子清洗机通过 “物理轰击 + 化学反应” 双重作用,实现精准、无损伤的污染物去除,具体包括:
有机污染物去除:如光刻胶残留、清洗剂残留、手指油污、聚合物杂质等。
原理:通入氧气(O₂)、空气等氧化性气体,等离子体中的高能氧自由基(・O)会与有机污染物发生氧化反应,将其分解为 CO₂、H₂O 等挥发性气体,再通过真空泵排出。
应用场景:光刻后残留胶去除、晶圆键合前表面清洁、封装引线键合区(Bond Pad)清洁。
无机污染物去除:如金属离子(Cu、Fe、Al 等)、氧化物(SiO₂、Al₂O₃等)、颗粒杂质(硅粉、金属碎屑)。
原理:
物理轰击:通入氩气(Ar)等惰性气体,等离子体中的高能离子(Ar⁺)会以高速撞击表面,将无机颗粒 / 氧化物 “剥离”;
化学反应:通入氢气(H₂)、氟化氢(HF,需特殊耐腐蚀腔体)等还原性 / 腐蚀性气体,与金属氧化物反应生成易挥发产物(如 H₂O、金属氟化物)。
应用场景:晶圆电镀前金属表面氧化物去除、MEMS 器件结构清洁、半导体封装焊盘(Pad)氧化层去除。

半导体制造中,许多后续工艺(如键合、涂胶、镀膜、焊接)对材料表面的 “附着力”“浸润性” 要求极高,而原生半导体表面(如硅、陶瓷、金属)往往存在疏水性或低活性,导致工艺失效(如键合开裂、涂胶不均)。等离子清洗机通过以下方式实现表面改性:
表面活化:打破材料表面原有化学键(如 C-C 键、Si-O 键),引入羟基(-OH)、羧基(-COOH)等极性基团,使表面从 “疏水” 变为 “亲水”,显著提升后续涂胶、镀膜的附着力。
例:晶圆键合(如直接键合、阳极键合)前,用 O₂或 N₂+H₂混合等离子处理硅片表面,活化后的表面能从 30 mN/m 提升至 60+ mN/m,确保键合强度达标。
表面刻蚀(微粗糙化):对表面进行 “微米级浅刻蚀”,形成微小凹凸结构(粗糙度 Ra 提升至 10-100nm),通过 “机械咬合” 进一步增强后续工艺的结合力。
应用场景:半导体封装中 “芯片 - 基板” 的粘片(Die Attach)前处理、柔性半导体(如 OLED 驱动芯片)的薄膜沉积前表面改性。

亲,如果您对等离子体表面处理机有需求或者想了解更多详细信息,欢迎点击普乐斯的在线客服进行咨询,或者直接拨打全国统一服务热线400-816-9009,普乐斯恭候您的来电!
下一篇:等离子清洗机在汽车工业中的应用(1) 上一篇:半导体等离子清洗机介绍(2)


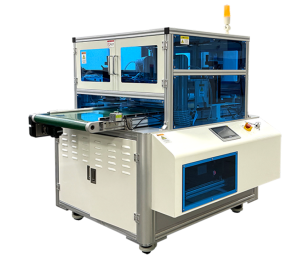





 苏公网安备 32058302002178号
苏公网安备 32058302002178号
